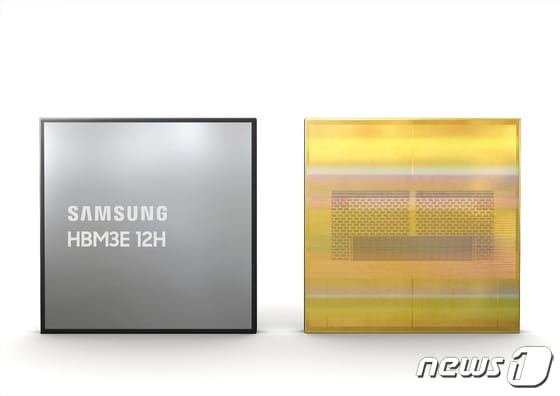 |
| 삼성전자가 업계 최초로 36GB 용량의 5세대 고대역폭 메모리 'HBM3E' 12H를 개발했다. 올해 상반기 중 양산에 돌입한다. (삼성전자 제공) © News1 |
삼성전자(005930)가 5세대 12H(12단) 고대역폭메모리(HBM)인 36기가바이트(GB) HBM3E 12H의 상용화로 인공지능(AI) 메모리 시장 공략에 나선다.
삼성전자는 18일 자사 뉴스룸에 게재한 윤재윤 DRAM개발실 상무와 김경륜 상품기획실 상무 인터뷰를 통해 HBM 사업을 소개했다. 삼성전자가 지난 2월 업계 최초로 개발한 12단 HBM3E는 현존 최대 용량과 초당 최대 1280GB의 대역폭을 자랑한다. 4세대인 8단 HBM3 대비 성능과 용량이 50% 이상 개선됐다.
김 상무는 "삼성전자의 36GB HBM3E 12H D램은 시장 주요 제품인 16GB HBM3 8H 대비 2.25배 큰 용량의 제품"이라며 "상용화하면 매우 빠른 속도로 주류 시장을 대체해 나갈 것"이라고 말했다.
이어 "기존보다 더 적은 수의 AI 서버로 동일한 초거대언어모델(LLM)을 서비스할 수 있어 총 소유비용(TCO)이 절감되는 효과가 있어 고객의 기대도 매우 높다"고 설명했다.
 |
| 김경륜 삼성전자 상품기획실 상무.(삼성전자 제공) © News1 한재준 기자 |
삼성전자의 5세대 HBM은 24Gb(기가비트) D램 칩을 12단으로 수직으로 쌓아 만들었다. 어드밴스드 열압착 비전도성 접착필름(TC-NCF)과 기술 노하우가 만난 성과다. NCF는 적층된 칩 사이를 절연하고 충격으로부터 연결 부위를 보호하기 위해 사용하는 고분자 물질이다.
윤 상무는 "(D램을) 많이 쌓을수록 데이터를 저장하는 코어 다이(D램 칩) 두께는 점점 얇아져 칩의 휘어짐이나 깨짐 현상으로 조립 난이도가 높아지고 열 저항이 커지는 문제가 발생한다"고 했다.
삼성전자는 칩 사이에 들어가는 NCF 두께를 줄이고 열압착 기술로 칩 간격을 줄여 고단 적층에서의 칩 제어 기술을 고도화했다. 12단 5세대 HBM은 칩 간 간격이 7마이크로미터(㎛)로 업계 최소 간격을 구현했다.
윤 상무는 "고온 열 특성에 최적화한 NCF 조립 기술과 최첨단 공정 기술을 통해 차세대 HBM4에 16H 기술까지 도입할 계획"이라고 강조했다.
 |
| 윤재윤 삼성전자 DRAM개발실 상무.(삼성전자 제공) © News1 한재준 기자 |
한편 삼성전자는 향후 HBM 시장이 △분할 △맞춤화 △파워 월 등 세 가지 변화를 겪을 것으로 내다봤다. 파워 월은 프로세서 및 메모리의 성능 향상에 따른 소모 전력 증가에도 전체 시스템단 파워가 한정돼 있는 현상을 뜻하며 이를 극복하기 위해서는 각 칩 단위에서 전력 효율 개선이 필요하다.
김 상무는 "차세대 HBM부터 로직 공정을 적용한 베이스 다이(다른 칩과 통신하는 역할을 하는 코어다이 하단 부분)가 도입되면서 파워 월을 해소하기 위한 첫 번째 혁신이 시작됐다면 현재의 2.5D에서 3D HBM으로 점차 진화하면서 두 번째 혁신을 맞이할 것"이라고 내다봤다.
그러면서 "HBM-PIM(지능형반도체)처럼 D램 셀과 로직이 더 섞이는 방향으로 진화하면서 세 번째 혁신을 맞이할 것으로 예상한다"고 덧붙였다.
hanantway@news1.kr











!['범죄도시4', 근로자의 날 하루 78만명 봤다…누적 579만명↑ [Nbox]](https://image.news1.kr/system/photos/2024/5/2/6627833/no_water.jpg/dims/resize/276/crop/276x184/thumbnail/138x92!/optimize)








